王姝予,徐英起
(沈阳建筑大学 材料科学与工程学院,辽宁 沈阳 110168)
引言ZnO作为Ⅱ-Ⅵ族宽禁带半导体材料,具有优良的化学稳定性和光电性能,是非常有发展前景的透明导电薄膜材料。但是本征ZnO中存在固有缺陷、导电性能较差且结晶质量较低等缺点,而掺杂可以调节ZnO的禁带宽度,提高ZnO的光电性能。
理论上,人们采用磁控溅射法、溶胶-凝胶法、金属有机化学气相沉积法、分子束外延法、喷雾热解法、电化学沉积法等方法对掺杂ZnO的相关性能进行实验研究。ParkW等研究者用Mg掺杂氧化锌薄膜,使得氧化锌薄膜的宽带禁度在3.2~3.8 eV的范围内变化,实现了氧化锌薄膜的禁带宽度变化[1]。BougrineA等采用超声喷雾热解法制备了Sn掺杂的氧化锌薄膜,研究发现Sn的掺入会改善薄膜的透过率,增大薄膜的晶体尺寸[2]。Saima等人用AACVD制备了NZO薄膜,研究得到氧化锌薄膜的禁带宽度最大可达到3.5 eV,在可见光及近红外范围内的透过率高于89%[3]。Ahmed等人采用直流磁控溅射制备了不同掺杂浓度的NZO薄膜,研究发现掺杂浓度增加,氧化锌的结晶度降低;当掺杂浓度为3.7%时,氧化锌薄膜的禁带宽度增加到了3.62 eV[4]。由于Nb掺杂ZnO透明导电薄膜的相关报导较少,本文将通过射频磁控溅射制备薄膜的方法,主要研究了磁控溅射气压对制备Nb掺杂ZnO透明导电薄膜的结构及光电性能影响。
1 实验本实验采用的设备是由沈阳科友真空技术有限公司生产的MS500B型高真空磁控溅射仪进行操作的,利用射频磁控溅射的方法,其本底真空度约为3×10-3Pa的氩气(纯度99.999%)气氛中沉积Nb掺杂ZnO薄膜。溅射所用陶瓷靶直径为75 mm,是在ZnO粉末中掺入含量为2%的Nb2O5粉末充分混合后压制而成的。NZO靶材的优点是高纯度且高密度。实验中采用玻璃作为衬底,衬底的具体规格为20mm×15mm×1.5 mm。实验前的准备首先是玻璃衬底的清洗,玻璃基片用肥皂去除表面污渍,然后按照丙酮、去离子水、乙醇偶溶液中的顺序分别超声清洗15 min,取出试验样品后用吹风机进行干燥,然后放入磁控溅射室内进行射频磁控溅射。
2 结果与讨论图1是不同溅射气压下沉积ZnO∶Nb(NZO)薄膜的XRD图谱,试验样品的溅射气压分别为3.4 Pa、5.4 Pa和8.4 Pa。从图1中可以明显的判断出,溅射气压从3.4 Pa增加到8.4 Pa的过程中,不同衍射峰的峰值根据不同的溅射气压下有不同的改变,但是没有出现其他晶体结构的相和衍射峰,这说明了NZO的结晶性能和溅射气压的改变有对应的影响,但是不影响薄膜的晶体结构,其中5.4 Pa条件下制备的ZnO薄膜晶化最明显,显示的峰值最高,这表明了此状态下的NZO薄膜结晶程度较好。
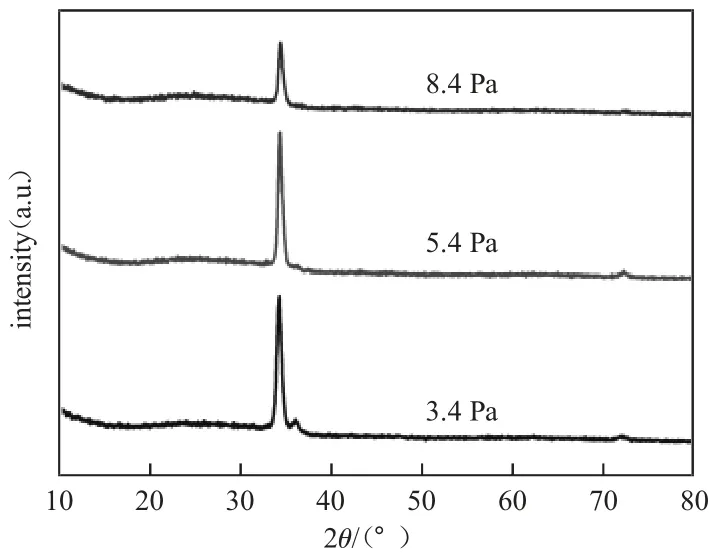
图1 不同溅射气压下NZO薄膜的XRD图谱
图2是不同溅射气压下制备Nb掺杂ZnO薄膜的半高宽(FWHM)和晶粒尺寸(Grain size)图谱。实验中,溅射气压升高,引起了NZO薄膜的晶粒尺寸先增大后减小的变化,FWHM先减小后增大的变化,晶界中的缺陷随着溅射气压先减小后增多。Nb掺杂ZnO薄膜在5.4 Pa条件下,晶粒尺寸最大,半高宽达到最小值,结晶状态最佳。
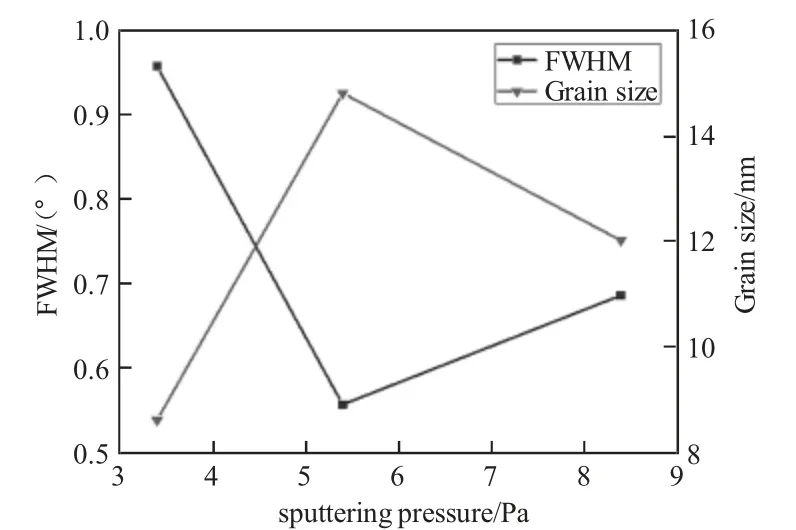
图2 不同溅射气压下NZO薄膜的半高宽和晶粒尺寸
实验溅射气压设置为3.4 Pa时的NZO薄膜,此时的粒子分子自由程较大,从而减小了溅射的碰撞机率。导致较高的动能在溅射粒子上附着,而粒子在达到衬底表面过程中不会碰撞到气体分子,会直接溅射在衬底上的薄膜,较大的冲击力会对薄膜结构造成一定程度上的损伤,由此产生一定程度的缺陷,导致再次溅射气压下的薄膜制备结晶性表现较差。当溅射气压设置为5.4 Pa时,其分子自由程减小,则增大了二者之间的碰撞机率,在溅射过程中腔体气氛和其他粒子引起摩擦,导致溅射粒子损失了部分能量之后达到了衬底表面。在此过程中导致溅射粒子的动能有所消耗,减小了对薄膜的晶体破坏,从而薄膜的结晶性能有所提高。实验中最高溅射气压设置为8.4 Pa,由于溅射气压的升高,导致大幅度减小了气体平均分子自由程,致使溅射过程中的碰撞几率大幅度增加,与腔体气氛中与其他离子发生强烈的摩擦碰撞,损失了溅射粒子的动能,减小薄膜的损伤,但因此降低了粒子的迁移率。在薄膜表面,溅射粒子的动能不能满足横向的迁移和扩散,会形成部分晶核,导致薄膜表面粗糙,减缓了薄膜的生长速度,反而对薄膜的结晶性能有很大的影响。从此实验规律可得出结论,过高和过低的气压都会降低薄膜的结晶性能,在制备薄膜时,对于溅射气压的控制要适度。
图3和图4分别是不同溅射气压下沉积ZnO∶Nb(NZO)薄膜的AFM(2D)图和AFM(3D)图。实验中通过原子力显微镜对溅射功率分别为3.4 Pa、5.4 Pa、8.4 Pa的3个样品进行表面测试,样品的扫描范围为1 μm×1 μm。溅射气压的大小意味着气体密度的大小,主要是指真空室内混合气体维持的含量,在溅射气压较低时,真空室内的气体密度较小,所以有较小的可能性会造成阴极电子和气体的碰撞,因而在靶材附近的等离子体浓度也小[5],同时溅射出去的粒子也少,导致达到基底表面的粒子数量较少,分布均匀并粗糙度小。
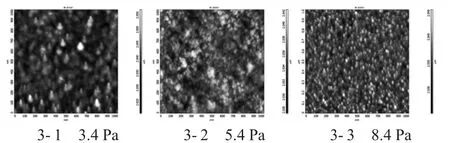
图3 不同溅射气压下NZO薄膜的AFM(2D)

图4 不同溅射气压下NZO薄膜的AFM(3D)
当溅射气压为3.4 Pa时,薄膜表面均匀性较差且分布着的颗粒粗大。溅射气压低,原子密度低,同时分子的平均自由程大,由于晶格成型需要足够长的时间,导致此时形成的晶核大多都较为不稳定,降低了薄膜的的表面能。随着溅射气压提高到5.4 Pa时,同时也增大了晶粒尺寸,其原因是溅射气压的提升增大了真空室内的气体密度,由于溅射过程中增大了原子的碰撞几率,衬底表面有更多的离子产生,而降低了分子的平均自由程。原子的动能在衬底表面形成的新晶核逐渐趋于稳定,最终形成的结构表面薄膜颗粒大且均匀性好。当溅射气压增加到8.4 Pa时,晶粒尺寸逐渐减小,随着真空室内气体密度的继续增大,造成了与其他粒子过大的碰撞可能性,导致大部分溅射粒子很难达到衬底表面,部分达到衬底表面的粒子在到达衬底时带有的能量较低,这对粒子到达衬底表面后的扩散迁移过程有很大的影响,粒子不易扩散会容易就近形成较大的晶粒,从而影响薄膜的均匀性。另外,由于溅射气压较大,被电离的气体较多,从而等离子浓度越高,在薄膜中会形成均匀性较差且晶粒尺寸较大的颗粒,使得薄膜的结晶性和结晶质量均变差。因此,适当提高溅射气压可以改善薄膜的结晶质量。
下页图5为不同溅射功率条件下制备的ZnO∶Nb(NZO)薄膜透过率与波长的关系曲线,其扫描范围在300~1 100 nm之间。薄膜样品中在400~1 100 nm波长范围内的平均透过率最大的是溅射气压为5.4 Pa下制备的NZO薄膜,在波长为467.4 nm处透过率呈急剧下降的趋势,然后在波长为591.5 nm处呈现上升的波动趋势。并且在溅射气压为5.4 Pa薄膜的晶粒尺寸较大,薄膜表现致密且平整度和结晶性较好且缺陷开空间和缺陷浓度较小,导致对载流子浓度的俘获较小,所以有较大的载流子浓度;当溅射气压增加到8.4 Pa时,溅射过程中的粒子之间发生了剧烈的碰撞,损害了NZO薄膜表面的组织结构,导致薄膜表面不平整,并加强了光的散射,导致透过率有所降低。
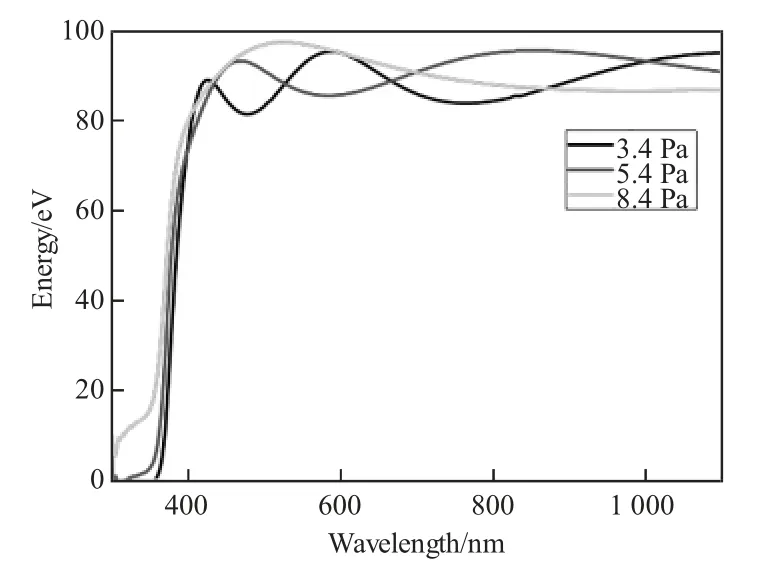
图5 不同溅射气压下NZO薄膜的透过率与波长图谱
下页图6为不同溅射气压下沉积ZnO∶Nb(NZO)薄膜的光学带隙值。由图6中可以看出,溅射气压分别为3.4 Pa、5.4 Pa、8.4 Pa情况下,光学带隙值分别为3.48 eV、3.52 eV和3.54 eV,本征ZnO的带隙宽度Eg=3.4 eV,NZO光学带隙值呈增大趋势,氧化锌半导体薄膜相关研究证明结果类似[6]。这可能是由于气体的平均自由程与溅射气压呈反比例线性关系,二者的碰撞机率随之变大,这样会导致减少原子之间的结合,从而降低了Nb的掺杂,产生薄膜的光学带隙随之变大的现象。

图6 不同溅射气压下NZO薄膜的光学带隙值
图7是不同溅射气压下沉积ZnO∶Nb(NZO)薄膜的PL图谱。ZnO薄膜主要呈现了一个紫外发光峰,说明Nb的引入没有造成大的晶格影响和畸变,在3.4 Pa、5.4 Pa和8.4 Pa溅射气压下,发光峰位置分别在403.2 nm、402.2 nm、400.5 nm,发光峰的位置随着溅射气压的增大而逐渐移动至短波方向。在350~700 nm波长范围里,出现一个宽的ZnO本征发光峰。随着溅射功率从3.4 Pa逐渐增加到8.4 Pa过程中,PL谱中紫外发光的峰位只在400~402 nm附近区域生长,没有明显的位移。但是不同条件下的发光峰强度有跟大的差距,本征激发紫外发光峰强度随着溅射气压的逐渐增加呈现逐渐增强的趋势,这说明薄膜的结晶质量逐渐增强,缺陷逐渐减小,随着溅射气压的增加,NZO薄膜的发光性能逐渐增高且本征发光峰的强度逐渐增强,其中,在8.4 Pa溅射气压条件下的ZnO本征发光峰明显突出,在溅射气压为3.4 Pa和5.4 Pa条件下相对较平缓。这是由于Nb离子进入氧化锌晶格内部代替锌离子过程中,在不同条件下有不同程度的缺陷,通过调整溅射条件使得晶格内部逐渐达到平衡,减少晶格内的缺陷密度,从而提高NZO的结晶质量,使得可见发光峰降低。因此,NZO薄膜的紫外发光峰强度越高,结晶度越强,越会促进激子复合和带间的跃迁程度。
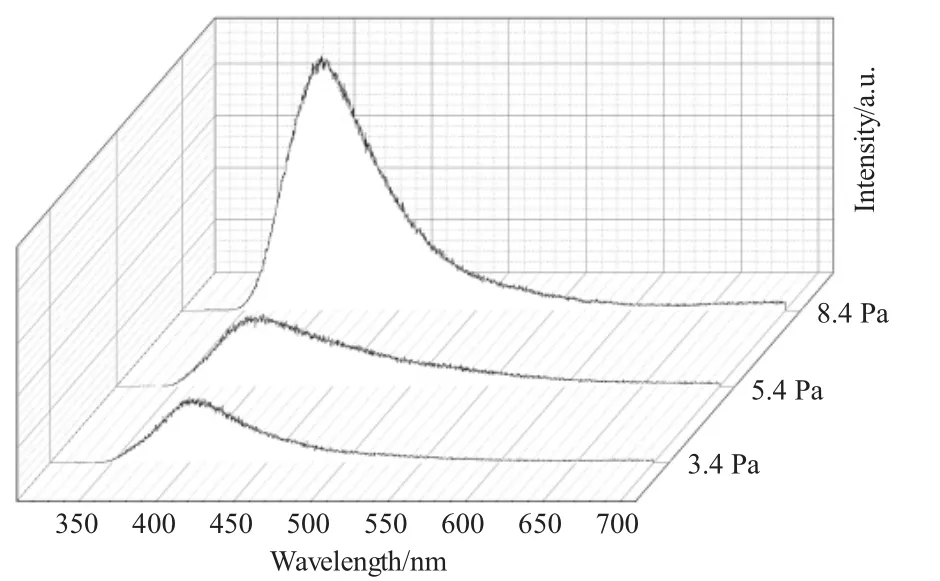
图7 不同溅射气压下NZO薄膜的PL图谱
3 结论本文采用射频磁控溅射法制备了Nb掺杂ZnO薄膜分析了溅射气压对NZO薄膜的结构及光电性能的影响。实验对比了当溅射气压分别为3.4 Pa、5.4 Pa和8.4 Pa的NZO薄膜的XRD、半高宽、晶粒尺寸、AFM、PL等图像分析,结果显示了在溅射功率为5.4 Pa下制备的NZO薄膜表面致密性和均匀性较好,晶粒尺寸较大,光学带隙从3.4 eV展宽3.52 eV,平均透过率达到86%以上,薄膜的综合性能最好。适当提高溅射气压可以提高薄膜的结晶程度,从而改善薄膜的光电性能。


