
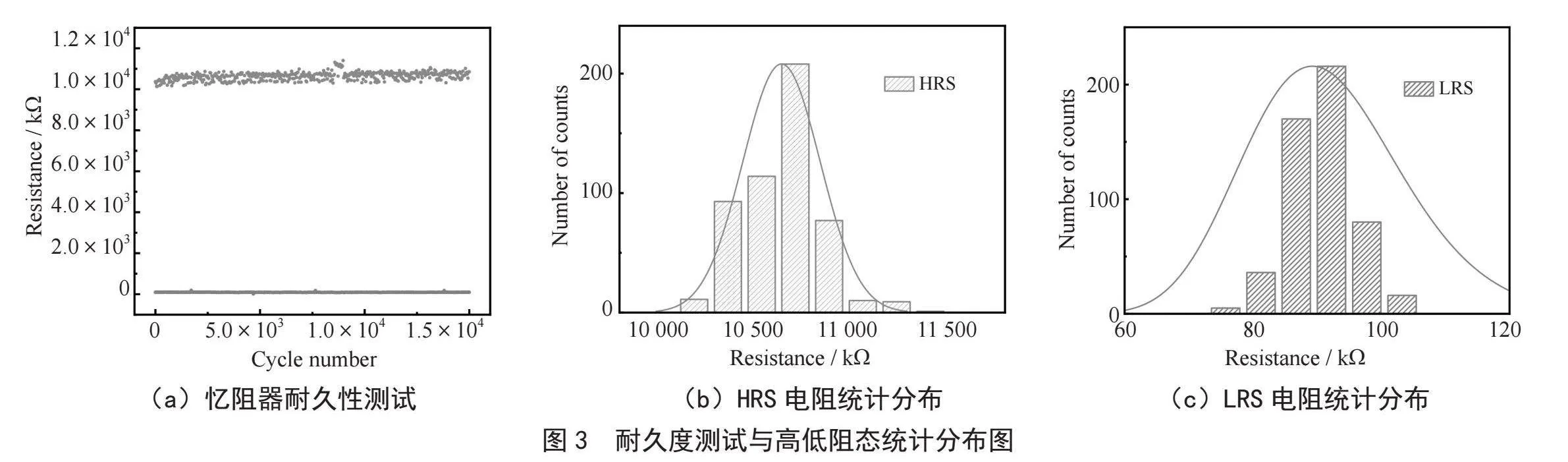
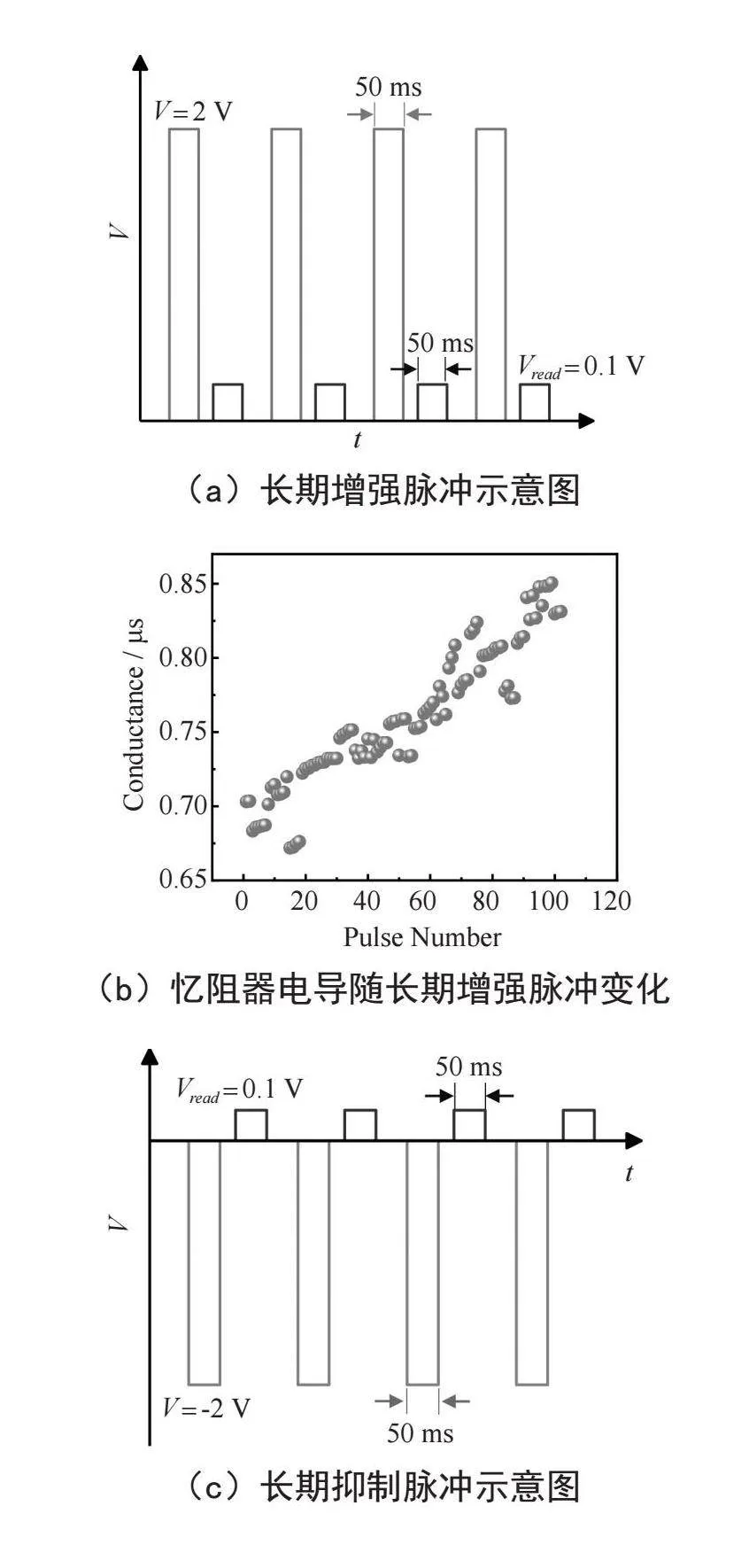
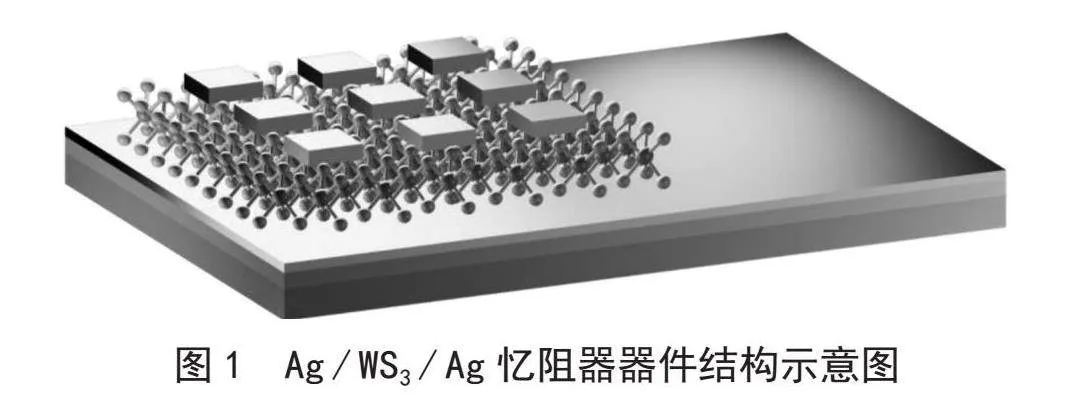


摘 要:对基于二维材料的垂直阵列忆阻器进行了研究。面对二维材料生长窗口狭窄,难以制备大面积单晶等挑战,通过可控电化学沉积沉积了大面积WS3薄膜。基于WS3薄膜制备了垂直阵列结构忆阻器件。对2×2的4个忆阻器单元进行I-V特性扫描,均展现出了双极性忆阻特性。开关寿命达1.5×104次,对于仿神经训练脉冲信号有着明显的响应。大面积二维材料的制备与稳定的忆阻性能为高集成度忆阻器件提供了关键的电学参数与广阔的应用前景。
关键词:忆阻器;WS3薄膜;阵列;脉冲
中图分类号:TP212 文献标识码:A 文章编号:2096-4706(2024)15-0024-04
Research on Electrochemical Deposition and Memristor Properties of WS3 Thin Film
DUAN Yaoyu, WAN Xi
(Engineering Research Center of the Ministry of Education of IoT Technology Application, Jiangnan University, Wuxi 214122, China)
Abstract: This paper researches a vertical array memristor based on two-dimensional materials. To address challenges like the narrow growth window of two-dimensional materials and the difficulty of producing large-area single crystals, large-area WS3 thin films are deposited through controlled electrochemical deposition. The I-V characteristics of four 2×2 memristor units are scanned, and all of them show bipolar memristor characteristics. The switch life of these devices reach up to 1.5×104 times, and they exhibit a clear response to simulated neural training pulse signals. The achievement of large area two-dimensional materials and the stable performance of the memristor offer crucial electrical parameters and promising application prospect for highly integrated memristor devices.
Keywords: memristor; WS3 thin film; array; pulse
0 引 言
忆阻器在1971年由蔡少棠教授基于电路理论逻辑关系的对称性提出[1]。由六种不同的数学关系联系着四个基本的电路变量:电压v、电流i、电荷q和磁通量φ,并将磁通量与电荷量相关联,认为忆阻器是除了电阻、电容、电感外的第四个基本电子元件。忆阻器与电阻有着相同的量纲,在特定的电学信号的刺激下,会产生周期性稳定的电阻水平的变换,而目前对忆阻器的研究中,分为高电阻状态(High resistance state, HRS)和低电阻状态(Low resistance state, LRS),HRS和LRS又被称之为关闭状态(Off State)和开启状态(On State)。当LRS不稳定时,复位过程会在电信号刺激关闭时自动发生。当LRS不稳定时,复位过程会在电信号刺激关闭时自动发生。这两种不同的状态可以在数字逻辑中表示不同的逻辑状态,即数字二进制中的0和1,这种有趣的特性使得忆阻器在电子存储[2-3]、开关器件[4]和人工神经网络[5-7]等方面产生了广阔的应用场景。
起初忆阻器都是由三维材料制成的立体结构器件。近年来,二维材料由于其诸多优异的性质逐渐兴起,两者的结合也引起了众多研究者的关注。然而,对于生长窗口的把握和如何大面积制备二维材料仍然是所面临的问题之一。本文中,采用电化学沉积的方法沉积了大面积WS3薄膜,并基于WS3薄膜制备了垂直阵列结构忆阻器,具有优异的忆阻性能,为大面积高集成度忆阻器的制备提供了可行性。
1 忆阻器制备
目前半导体行业对于忆阻器最常规的选择是垂直MIM(Metal/Insulator/Metal)的交叉阵列结构的忆阻器。本实验采用Ag / WS3 / Ag垂直阵列结构的忆阻器,如图1所示为MIM忆阻器结构示意图。底部为一层Ag底电极,中间层为WS3薄膜,顶部为Ag制备的阵列结构顶电极。
切割大小约为1.5 cm×1.5 cm的Si / SiO2衬底。对Si / SiO2衬底进行清洗,将衬底在丙酮溶液中浸泡并进行超声波清洗,时间为10 min。捞出衬底后将其浸入异丙醇溶液并进行超声波清洗以去除残余的丙酮溶液,时间为10 min。取出衬底后使用去离子水冲洗残余的异丙醇溶液,最后使用氮气枪吹干。
在清洗过后的Si / SiO2衬底上热蒸发一层约100 nm厚Ag薄膜,Ag具有优异的导电性,可以作为电化学沉积制备WS3薄膜的衬底,同时在垂直忆阻器结构中充当器件的底电极。电化学沉积过程中,使用碳棒作为阴极,Ag衬底作为阳极,将两个电极同时浸入浓度为10 mg/mL的四硫代钨酸铵((NH4)2WS4,Sigma-Aldrih,纯度为99.9%)水溶液中。选择电化学工作站的计时电位测定法(Chronopotentiometry, CP)。在水溶液中会发生如式(1)和式(2)所示的化学反应式。通过反应式可以看出,在导电性优异的Ag衬底上可以沉积一定厚度且大面积的WS3薄膜[8]。
(1)
(2)
选择阳极通入电流密度为500 μA / cm2的直流电流,沉积时间为180 s的WS3薄膜来制备Ag / WS3 / Ag忆阻器。通过掩膜在WS3薄膜上热蒸发厚度约为100 nm的Ag,用作忆阻器的顶电极,形状为如图1所示的方形阵列结构,大小为0.3 mm×0.3 mm,间距为0.3 mm。完成Ag / WS3 / Ag垂直阵列结构忆阻器的制备。
2 测试结果和分析
2.1 忆阻器I-V特性测试
在室温下对忆阻器2×2阵列的4个忆阻器单元进行0 V→2 V→-2 V→0 V的I-V特性曲线扫描,测试结果如图2所示。在测试的过程中,施加斜坡电压应力(Ramped Voltage Stresses, RVS)[9],将电压刺激信号施加在了顶层Ag电极上。其中每个忆阻器单元进行了20次左右的循环扫描测试。可以看出Ag / WS3 / Ag忆阻器经历了20次循环操作后依然能表现出良好的双极型阻变行为。Ag / WS3 / Ag忆阻器的初始状态为高阻态,将电压从0 V扫描至+2 V,过程中,器件的电流先是以一个缓慢的状态线性增加,直至电压到达某一阈值后,电流突然急剧增加,这是期间内部的导电通道已然形成,忆阻器的电阻状态由高阻态转换至低阻态,实现了置位(Set)过程。当电压从0 V扫描至-2 V时,与置位过程相似,在某一个电压阈值处,器件的电流骤减,忆阻器的电阻状态由低阻态转换至高阻态,实现了复位(Reset)过程。需要注意的是,忆阻器在进行首次I-V特性扫描的时候,需要设置一个比常规测试电压更大电压大的电信号来对忆阻器进行写入,也称作Forming Voltege。
对数十条Ag / WS3 / Ag忆阻器的捏滞回线进行观测统计,可以大概得出Ag / WS3 / Ag忆阻器的置位电压约为0.6 V,复位电压约为-1.3 V,表明了忆阻器拥有较为稳定的运行电压,且功耗较低。
为了防止电流过大而烧损器件,在忆阻器的测试进行限流是十分必要的。本实验的I-V特性测试中使用了Keithley 4200-SCS参数分析仪的SMU源测量单元,自带限流功能。图1中所示的4个忆阻器单元中,对器件均限制了1 mA的饱和电流。本实验中选择了制备面积相对较大的电极,测试结果表现,在Ag /WS3 / Ag忆阻器中,中间层所采用电化学沉积的WS3薄膜具有很好的均匀度,大面积的制备与较低的功耗,使得Ag / WS3 / Ag忆阻器在后续的低功耗、高集成度器件中有着可观的前景。
2.2 忆阻器耐久性与稳定性测试
稳定性与耐久性通常表现为忆阻器最关键的性质之一,忆阻器稳定性与耐久性的测试中,可以通过施加脉冲电压应力(Pluse Voltage Stresses, PVS)来对忆阻器进行高阻态与低阻态的切换。通常采用比置位电压(Set Voltage)与复位电压(Reset Voltage)更大的脉冲电压应力来激励忆阻器进行高低阻态的状态切换,对忆阻器施加正脉冲电压应力时,忆阻器发生置位过程,进入低阻态。对忆阻器施加负脉冲电压应力时,忆阻器发生复位过程,状态切换回高阻态。在施加的脉冲电压应力后面插入更小的读取电压来读取忆阻器的阻值状态。将读取电压与过程中读取电流的值相除,则可以得出忆阻器在不同阻态的阻值,此过程一般由测试设备自动计算。通常测试中都采用矩形PVS来对忆阻器进行测试。
如图3所示为对忆阻器进行长期增强与长期抑制测试,对Ag / WS3 / Ag忆阻器施加了2 V与-2 V的脉冲电压应力,脉冲信号的幅值大于上文中统计所得的0.6 V的置位电压与-1.3 V的复位电压,确保Ag / WS3 / Ag忆阻器能在脉冲电压应力的激励下进行高阻态与低阻态的切换。施加的脉冲信号脉冲宽度为50 ms。在每30个脉冲后加入一个读取脉冲,读取脉冲幅值为0.1 V,脉冲宽度为50 ms,进行500次循环。以此对Ag / WS3 / Ag忆阻器施加15 000个脉冲电压应力后,忆阻器仍能保持稳定的开关状态。对Ag / WS3 / Ag忆阻器15 000次脉冲序列测试中高阻态的阻值与低阻态的阻值进行统计分布,可以得出Ag / WS3 / Ag忆阻器在高阻态时的阻值约为1.08×107 Ω,在低阻态时的阻值约为9×104 Ω。开关比高达120左右。表明Ag / WS3 / Ag忆阻器具有优异的稳定性与耐久性。
2.3 忆阻器脉冲特性测试
忆阻器对脉冲有着特殊的响应且可以制作为垂直阵列结构,作为仿人工突触型器件。长期增强(Long-Term Potentiation, LTP)和长期抑制(Long-Term Depression, LTD)之间的对称突出权重更新特性是设计仿人工突触器件的关键特性,可以直接影响神经形态计算与的学习精度[10]。可以通过编程脉冲幅值、脉冲宽度和脉冲数量等PVS的参数,来测量忆阻器的长期可塑性。
图4(a)为编程的正脉冲序列示意图。脉冲幅值为2 V,脉冲宽度为50 ms,在每个脉冲信号后跟随一个读取脉冲,幅值为0.1 V,脉冲宽度为50 ms。图4(c)为编程的负脉冲序列示意图。脉冲幅值为-2 V,脉冲宽度为50 ms,在每个脉冲信号后跟随一个读取脉冲,幅值为0.1V,脉冲宽度为50 ms。每个增强和抑制脉冲各施加100个循环。Ag / WS3 / Ag忆阻器在双向脉冲的刺激下获得了双向开关的行为。如图8(b)所示,长期增强脉冲会逐渐增加忆阻器电导,器件被置位为低阻态,电导被设置为由0.65 μs逐渐增强至0.85 μs的导通状态。如图8(d)所示,长期抑制脉冲会逐渐减小忆阻器电导,器件被重置为高阻态,电导被设置为由0.06 μs逐渐降低至0.04 μs的导通状态。表明由Ag / WS3 / Ag结构制成的忆阻器可以支持重要的神经突触功能,与神经元通过离子流来调节突触权重高度相似。
3 结 论
本研究采用电化学沉积技术,在导电Ag衬底上沉积了厘米级别面积的WS3薄膜,制备了垂直结构阵列忆阻器。对2×2的4个忆阻器单元进行了测试。每个忆阻器单元均表现出了良好的忆阻特性与稳定性。其置位电压约为0.6 V,复位电压约为-1.3 V,器件开关运行稳定且具有较低的功耗。在正负脉冲应力的刺激下,器件的高低阻态切换次数可高达1.5×104次,开关比高达120。对忆阻器施加连续增强和连续抑制的脉冲信号来调控器件的电导,器件展现出了明显的响应。Ag / WS3 / Ag忆阻器拥有良好的忆阻性能、耐久性以及神经突触响应。大面积的二维材料制备与垂直阵列结构使其在超高集成度的电子开关、神经网络与仿人工突触器件等方面有着广阔的发展前景。
参考文献:
[1] CHUA L. Memristor-the Missing Circuit Element [J].IEEE Transactions on Circuit Theory,1971,18(5):507-519.
[2] 蔡振扬,刘苡萌,徐红梅.一种基于忆阻器的2T2M存储阵列的设计研究 [J].延边大学学报:自然科学版,2023,49(3):257-261.
[3] 吴磊.基于氧化物忆阻器的阻变存储与神经突触特性研究 [D].西安:西安电子科技大学,2020.
[4] KIM M,PALLECCHI E,GE R,et al. Analogue Switches Made from Boron Nitride Monolayers for Application in 5G and Terahertz Communication Systems [J].Nature Electronics,2020,3(8):479-485.
[5] 毛成烈,高小玉,南海燕.二维TMC忆阻器在神经形态计算中的研究进展 [J].半导体技术,2024,49(2):109-122.
[6] WEI W,SUN H,DONG X,et al. A Neotype Self-Rectifying Cu3SnS4-MoO3 Synaptic Memristor for Neuromorphic Applications [J/OL].Chemical Engineering Journal,2024,482:148848(2024-02-15).https://doi.org/10.1016/j.cej.2024.148848.
[7] 黄鹤鸣.基于过渡金属氧化物忆阻器的人工突触、人工神经元及人工神经网络 [D].武汉:华中科技大学,2021.
[8] WAN X,CHEN K,CHEN Z,et al. Controlled Electrochemical Deposition of Large-Area MoS2 on Graphene for High-Responsivity Photodetectors [J/OL].Advanced Functional Materials,2017,27(19):1603998(2017-01-11).https://doi.org/10.1002/adfm.201603998.
[9] LANZA M,WASER R,IELMINI D,et al. Standards for the Characterization of Endurance in Resistive Switching Devices [J].ACS Nano,2021,15(11):17214-17231.
[10] KIM M,YOO K,JEON S P,et al. The Effect of Multi-Layer Stacking Sequence of TiO(x) Active Layers on the Resistive-Switching Characteristics of Memristor Devices [J/OL].Micromachines(Basel),2020,11(2):154(2020-01-30).https://doi.org/10.3390/mi11020154.
作者简介:段尧禹(1995.07—),男,汉族,吉林白山人,硕士在读,研究方向:二维材料;通讯作者:万茜(1985.10—),男,汉族,江苏无锡人,副教授,博士,研究方向:二维材料。